Niadtong 1965, ang co-founder sa Intel nga si Gordon Moore mipahayag sa gitawag nga "Moore's Law." Sulod sa kapin sa tunga sa siglo, kini nagpaluyo sa makanunayong pag-uswag sa integrated-circuit (IC) performance ug pagkunhod sa gasto—ang pundasyon sa modernong digital nga teknolohiya. Sa laktod nga pagkasulti: ang gidaghanon sa mga transistor sa usa ka chip halos modoble matag duha ka tuig.
Sulod sa mga katuigan, ang pag-uswag nagsunod sa maong ritmo. Karon ang sitwasyon nag-usab-usab. Ang dugang nga pagkunhod nahimong lisod; ang gidak-on sa mga bahin mikunhod ngadto sa pipila na lang ka nanometer. Ang mga inhenyero nakasinati og mga limitasyon sa pisikal, mas komplikado nga mga lakang sa proseso, ug nagkataas nga gasto. Ang gagmay nga mga geometriya nagpakunhod usab sa abot, nga nagpalisud sa taas nga gidaghanon sa produksiyon. Ang pagtukod ug pag-operate sa usa ka nanguna nga pabrika nanginahanglan og dakong kapital ug kahanas. Busa, daghan ang nangatarungan nga ang Balaod ni Moore nagkawala na og kusog.
Kana nga pagbag-o nagbukas sa pultahan ngadto sa usa ka bag-ong pamaagi: mga chiplet.
Ang chiplet usa ka gamay nga die nga adunay espesipikong gimbuhaton—usa ka hiwa sa kaniadto usa ka monolithic chip. Pinaagi sa pag-integrate sa daghang chiplets sa usa ka pakete, ang mga tiggama makahimo sa pag-assemble sa usa ka kompleto nga sistema.
Sa panahon sa monolitiko, ang tanang gimbuhaton anaa sa usa ka dako nga die, busa ang depekto bisan asa mahimong makaguba sa tibuok chip. Uban sa mga chiplet, ang mga sistema gitukod gikan sa "known-good die" (KGD), nga makapauswag pag-ayo sa ani ug kahusayan sa paggama.
Ang heterogeneous integration—paghiusa sa mga die nga gitukod sa lain-laing mga process node ug alang sa lain-laing mga function—naghimo sa mga chiplet nga labi ka gamhanan. Ang mga high-performance compute block makagamit sa pinakabag-ong mga node, samtang ang memory ug analog circuits magpabilin sa hamtong ug cost-effective nga mga teknolohiya. Ang resulta: mas taas nga performance sa mas ubos nga gasto.
Ang industriya sa awto labi nga interesado. Gigamit sa mga dagkong tiggama og awto kini nga mga teknik aron mapalambo ang umaabot nga mga in-vehicle SoC, nga adunay target nga kaylap nga pagsagop pagkahuman sa 2030. Ang mga chiplet nagtugot kanila sa pag-scale sa AI ug graphics nga mas episyente samtang nagpauswag sa mga ani—nga nagpalambo sa performance ug functionality sa mga automotive semiconductor.
Ang ubang mga piyesa sa awto kinahanglan nga makatuman sa estrikto nga mga sumbanan sa kaluwasan sa pag-andar ug busa nagsalig sa mga karaan ug napamatud-an nga mga node. Samtang, ang mga modernong sistema sama sa advanced driver-assistance (ADAS) ug software-defined vehicles (SDV) nanginahanglan labi ka daghang compute. Ang mga chiplet nagtabon sa kana nga kal-ang: pinaagi sa paghiusa sa mga safety-class microcontroller, dako nga memorya, ug kusgan nga mga AI accelerator, ang mga tiggama makapahaum sa mga SoC sa mga panginahanglanon sa matag automaker—nga mas paspas.
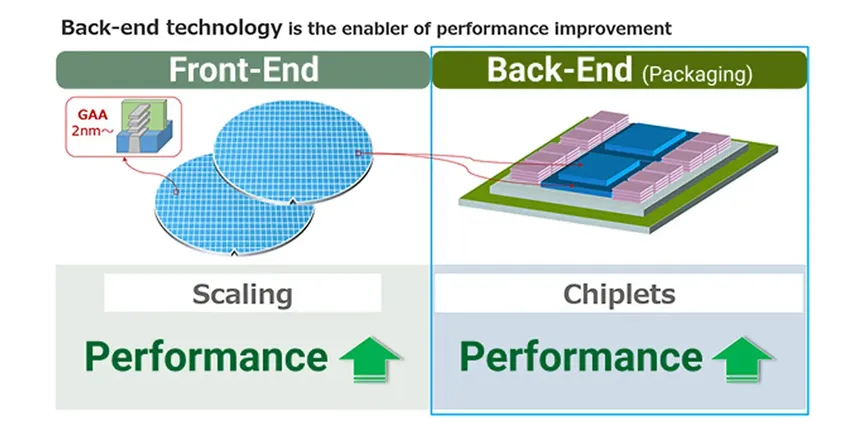
Kini nga mga bentaha labaw pa sa mga awto. Ang mga arkitektura sa chiplet mikaylap sa AI, telecom, ug uban pang mga natad, nga nagpadali sa kabag-ohan sa lainlaing mga industriya ug paspas nga nahimong haligi sa roadmap sa semiconductor.
Ang pag-integra sa chiplet nagdepende sa compact, high-speed die-to-die connections. Ang importanteng enabler mao ang interposer—usa ka intermediate layer, kasagaran silicon, sa ilalom sa mga die nga nag-ruta sa mga signal sama sa usa ka gamay nga circuit board. Ang mas maayong mga interposer nagpasabot og mas hugot nga coupling ug mas paspas nga signal exchange.
Ang abanteng pagputos nagpauswag usab sa paghatud sa kuryente. Ang dasok nga mga han-ay sa gagmay nga mga koneksyon sa metal taliwala sa mga die naghatag og igong agianan alang sa kuryente ug datos bisan sa pig-ot nga mga wanang, nga nagtugot sa pagbalhin sa taas nga bandwidth samtang naghimo sa episyente nga paggamit sa limitado nga lugar sa pakete.
Ang kasagarang pamaagi karon mao ang 2.5D integration: pagbutang og daghang dies nga magkatapad sa usa ka interposer. Ang sunod nga lakang mao ang 3D integration, diin ang mga dies gipatong-patong nga patindog gamit ang through-silicon vias (TSVs) para sa mas taas nga densidad.

Ang paghiusa sa modular chip design (pagbulag sa mga function ug circuit type) uban sa 3D stacking moresulta sa mas paspas, mas gagmay, ug mas episyente sa enerhiya nga mga semiconductor. Ang co-locating memory ug compute mohatag og dakong bandwidth sa dagkong mga dataset—sulundon para sa AI ug uban pang high-performance workloads.
Apan, ang bertikal nga pagpatong-patong nagdala og mga hagit. Mas dali nga magtigom ang kainit, nga nagpakomplikado sa pagdumala ug ani sa kainit. Aron matubag kini, ang mga tigdukiduki nagpalambo sa bag-ong mga pamaagi sa pagputos aron mas maayo nga madumala ang mga limitasyon sa kainit. Bisan pa niana, kusog ang momentum: ang panagtagbo sa mga chiplet ug 3D integration kaylap nga giisip nga usa ka disruptive paradigm—andam nga magdala sa sulo diin ang Balaod ni Moore mohunong.
Oras sa pag-post: Oktubre 15, 2025
