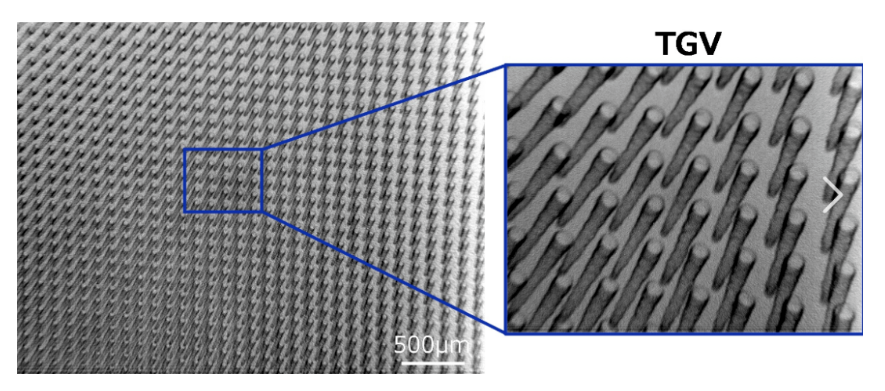
Unsa ang TGV?
TGV, (Pinaagi sa bildo), usa ka teknolohiya sa paghimo og mga lungag sa ibabaw sa usa ka substrate nga bildo. Sa yanong pagkasulti, ang TGV usa ka taas nga bilding nga mobuslot, mopuno, ug mokonektar pataas ug paubos sa bildo aron makahimo og integrated circuits sa salog nga bildo. Kini nga teknolohiya giisip nga usa ka importanteng teknolohiya alang sa sunod nga henerasyon sa 3D packaging.

Unsa ang mga kinaiya sa TGV?
1. Istruktura: Ang TGV usa ka bertikal nga molusot nga konduktibo agi sa lungag nga gihimo sa usa ka substrate nga bildo. Pinaagi sa pagdeposito sa usa ka conductive metal layer sa pore wall, ang ibabaw ug ubos nga mga layer sa mga electrical signal konektado.
2. Proseso sa Paggama: Ang paggama sa TGV naglakip sa substrate pretreatment, paghimo og lungag, pagbutang og metal layer, pagpuno sa lungag ug pagpatag. Ang kasagarang mga pamaagi sa paggama mao ang chemical etching, laser drilling, electroplating ug uban pa.
3. Mga bentaha sa aplikasyon: Kon itandi sa tradisyonal nga metal through hole, ang TGV adunay mga bentaha sa mas gamay nga gidak-on, mas taas nga densidad sa mga kable, mas maayo nga performance sa heat dissipation ug uban pa. Kaylap nga gigamit sa microelectronics, optoelectronics, MEMS ug uban pang natad sa high-density interconnection.
4. Trend sa Pag-uswag: Uban sa pag-uswag sa mga produktong elektroniko padulong sa miniaturization ug taas nga integration, ang teknolohiya sa TGV nakadawat og dugang nga atensyon ug aplikasyon. Sa umaabot, ang proseso sa paggama niini padayon nga ma-optimize, ug ang gidak-on ug performance niini padayon nga molambo.
Unsa ang proseso sa TGV:
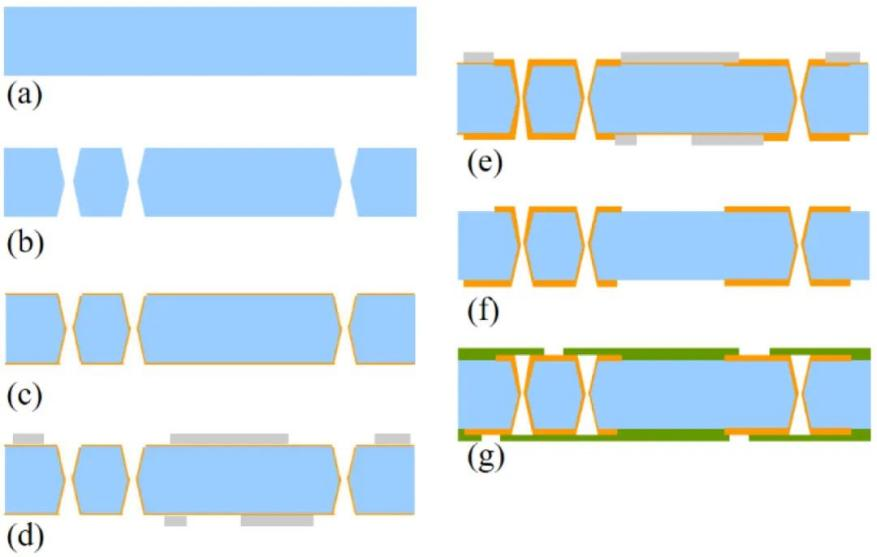
1. Pag-andam sa substrate nga bildo (a): Andama ang substrate nga bildo sa sinugdanan aron masiguro nga ang nawong niini hamis ug limpyo.
2. Pagbarina og bildo (b): Gigamit ang laser aron maporma ang lungag nga mosulod sa substrate sa bildo. Ang porma sa lungag kasagaran conical, ug human sa pagtambal gamit ang laser sa usa ka kilid, kini balihon ug iproseso sa pikas nga kilid.
3. Metalisasyon sa bungbong sa lungag (c): Ang metalisasyon gihimo sa bungbong sa lungag, kasagaran pinaagi sa PVD, CVD ug uban pang mga proseso aron maporma ang usa ka konduktibo nga layer sa liso sa metal sa bungbong sa lungag, sama sa Ti/Cu, Cr/Cu, ug uban pa.
4. Litograpiya (d): Ang nawong sa substrate sa bildo gitabonan og photoresist ug gi-photopattern. Ibutyag ang mga bahin nga dili kinahanglan og plating, aron ang mga bahin lang nga kinahanglan og plating ang makita.
5. Pagpuno sa lungag (e): Pag-electroplating sa tumbaga aron mapuno ang bildo pinaagi sa mga lungag aron maporma ang kompleto nga agianan sa konduktibo. Kasagaran gikinahanglan nga ang lungag hingpit nga mapuno nga walay mga lungag. Timan-i nga ang Cu sa dayagram wala pa hingpit nga mapuno.
6. Patag nga nawong sa substrate (f): Ang ubang mga proseso sa TGV mopatag sa nawong sa napuno nga substrate nga bildo aron masiguro nga ang nawong sa substrate hamis, nga makatabang sa sunod nga mga lakang sa proseso.
7. Panalipod nga lut-od ug koneksyon sa terminal (g): Usa ka panalipod nga lut-od (sama sa polyimide) ang giporma sa ibabaw sa substrate sa bildo.
Sa laktod nga pagkasulti, ang matag lakang sa proseso sa TGV kritikal ug nanginahanglan ug tukma nga pagkontrol ug pag-optimize. Sa pagkakaron, nagtanyag kami og teknolohiya sa TGV glass pinaagi sa lungag kon gikinahanglan. Palihug ayaw pagpanuko sa pagkontak kanamo!
(Ang impormasyon sa ibabaw gikan sa Internet, gisensor)
Oras sa pag-post: Hunyo-25-2024
